AI行使迅疾普及,高速运作芯片洪量导入进步封装,推升封测需求,台积电「CoWoS」成为家喻户晓的进步封装技巧。除了CoWoS以外,台积电也主动开拓下一代封装技巧如「CoPoS」,意即把CoWoS面板化,透过「化圆为方」来提拔面积操纵率与单元产量。另有一种「CoWoP」也被誉为次世代封装技巧,把芯片和中介层直接装正在高精度PCB板之上,有助于芯片散热,但两者正在开拓进程都面对差别的寻事,尚待战胜。
遵照工研院产科邦际所预估,2025年台湾半导体封测财富产值将达新台币7,104亿元,年生长率达13.9%。 2026年,正在AI/HPC根底步骤大范畴安插需求下,封测产值将平静生长至7,590亿元,年增6.8%。

工研院产科邦际所阐明师陈靖函流露,跟着摩尔定律逐步亲切物理极限,简单芯片上的电晶体数目已难以赓续呈指数生长,封装技巧遂成为确定芯片效力的枢纽。透过将众个小芯片慎密整合于简单IC中,可有用提拔数据传输频宽,并低重能耗与延迟,对寻觅极致追念体频宽与低延迟的AI芯片尤为枢纽。
为知足这些需求,AI加快器遍及采用HBM(高频宽追念体),使得如CoWoS(Chip-on-Wafer-on-Substrate)等可整合逻辑芯片与HBM的进步封装技巧,成为AI芯片供应链中的枢纽解方。
他进一步指出,半导体业界正赓续研发透过异质整合将芯片互联技巧,维系进步、成熟制程节点,来策画、创制最新的SoC单芯片体系;再操纵进步封装技巧,抵达低重本钱、缩短产物上市岁月、提拔体系效力的主意;而2.5D和3D封装技巧恰是完成对象的枢纽。
为了知足客户需求,台积电主动构造进步封装,开拓出CoWoS、InFO 以及SoIC 等技巧,正在竹科、中科、南科、嘉义都具备肯定的产能。该公司指出,从2022年到2026年,SoIC 产能伸长的年复合生长率(CAGR)将赶过100%,CoWoS 产能伸长的年复合生长率将赶过80%。

CoWoS 还细分为CoWoS-S、CoWoS-R 和CoWoS-R。台积电正在10众年前就已开拓出采用硅中介层封装的CoWoS-S技巧,但由于制价腾贵,自后连接开拓出RDL Interposer(从头散布层)版本的CoWoS-R;和Si Bridge(硅桥)版本的CoWoS-L,正在务必跟尾的高频宽处做维系,主意是低重本钱。
正在AI行使崛起后,台积电CoWoS-L 需求大幅提拔,销量是CoWoS 系列产物中最高的,约占六成。与CoWoS-S 相较,它的本钱较为低廉,也能整合被动元件以及平静电压的元件,进而优化能源效力。
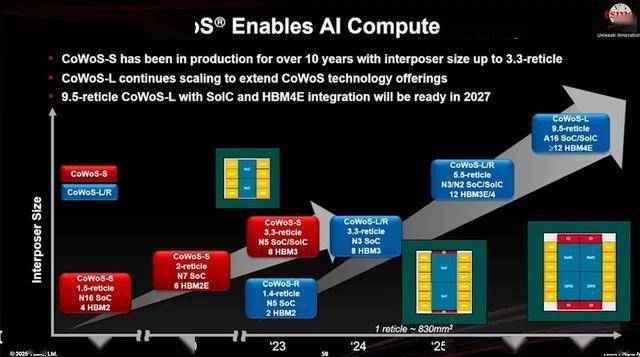
CoWoS属于2.5D封装,而台积电3D封装技巧则网罗SoIC-P和SoIC-X,前者采用微凸块堆迭封装;后者则采用Hybrid Bonding(混杂键合)技巧(注)。
遵照美媒报导,台积电正在美邦兴筑的2座进步封装厂,将用心于CoPoS和SoIC封装技巧,计画正在2026年启动CoPoS测试临蓐处事,对象2027岁尾告终与团结伙伴之间的验证处事。
因为亚利桑那进步封装厂尚未动土,目前CoWoS进步封装采纳与美商Amkor(艾克尔)团结式样,来减缓产能不够的情状。 Amkor正在亚利桑那皮奥里亚市将筑置1座价格20亿美元的进步封测步骤,估计2028年头投产。
正在台湾部门,据清楚,台积电将透过子公司采钰科技,于2026年设立首条CoPoS实践线厂启动量产。
IDC资深钻研司理曾冠玮近期受访流露,预估两年内,台积电进步封装扩产重心依旧以CoWoS为主,估计来岁产能将生长60%,CoPoS将依计画于2028年量产。预计正在那一年,将有5%进步封装产能从CoWoS移转至CoPoS;此中,ASIC编制的自研芯片业者如Google、AWS较不需求大尺寸面板封装,反而是GPU编制如辉达或者会采用CoPoS封装。
除了台积电以外,日月光于全台北中南筑置进步封装产能,亦是环球最大的OSAT半导体封测厂。而海外厂商如英特尔则于美邦、马来西亚两地筑置封装产能;三星构造更广,网罗韩邦本地、中邦和美都城有设厂。
陈靖函以为,对OSAT委外封测厂而言,正在海外设厂将使营运本钱扩大,这是无可避免的。而封测厂的毛利或者不到晶圆厂(近60%)的一半,议价本领会是以受限,但即使不随着去海外设厂,客户或者会转向外地供应链,以至或者影响到团体供应链的平静性。
正在AI重大需求下,进步封装让芯片量产岁月逐步缩短,从客户策画定案(Tape-out)到量产,过去是7个季度,约一年半岁月来开拓一颗IC,此刻搭配进步封装技巧,进程已缩短至3个季度,也即是不到一年就告终。
陈靖函指出,云云的改制对全面供应链变成极大压力,IC创制业务必正在产物创制时,一边加入开拓和验证处事,也检验供应链的弹性配合度。近年来,业界创建了3DIC进步封装创制同盟和硅光子财富同盟,即是希冀加强业界整协力道。
下一代封装技巧网罗CoPoS、CoWoP(Chip-on-Wafer-on-PCB),旨正在低重本钱。正在技巧主旨部门,相较CoWoS是先整合芯片与硅中介层,再装配到ABF基板上。 CoPoS(Chip-on-Panel-on-Substrate)则是把芯片布列正在矩形基板上,末了再透过封装制程连合真相层的载板上,让众颗芯片可能封装。
换句话说,CoPoS是将蓝本的圆形硅中介层,改用310×310mm矩形面板,也即是把CoWoS「面板化」,透过「化圆为方」来提拔面积操纵率与单元产量。至于CoWoP是本年新涌现的进步封装途径。则无须应用ABF基板,把芯片和中介层直接装正在高精度PCB板之上。
除了CoWoS以外,后面两者皆正在开拓中。 CoPoS首要寻事来自于面板翘曲度的限制,且散热效力受限于ABF基板,需特地加装散热治理计划。而CoWoP因采用精简途径和跟尾大面积的PCB板,将有助于芯片散热,但高精度PCB创制为其最大寻事。
电话:400-123-4657
地址:广东省广州市天河区88号
